電流測試
我們可以通過電流來判斷芯片的工作狀態時,首先先了解下芯片的電流是如何產生的。
靜態電流
理論上,CMOS結構的芯片靜態時幾乎不耗電
- CMOS基本結構:Pmos + Nmos 串聯
- 當邏輯電平穩定時:
? 要么Pmos導通,Nmos斷開
? 要么Nmos導通,Pmos斷開
? 整體不會形成直流通路 ? 所以靜態電流接近0
如下,利用經典的反相器來解釋這一原理:
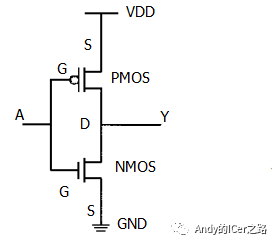
| 輸入 | 動作 | 輸出 | 結論 |
|---|---|---|---|
| 高電平 | PMOS關,NMOS開,**VDD (斷了) ? **GND (通過NMOS) | 低電平 | 只有NMOS開,但沒有VDD到GND直接導通 ? 所以沒有直流電流 |
| 低電平 | PMOS開,NMOS關,**VDD *(通過PMOS) ? **GND (斷了) | 高電平 | 只有PMOS開,但還是沒有VDD到GND直接通路 ? 靜態電流近乎0 |
結論:
-
邏輯電平穩定時(比如芯片沒動靜的時候)
-
? 要么PMOS通,NMOS斷
-
? 要么NMOS通,PMOS斷
-
? 電流不會從VDD直接流到GND ? 所以理論上****靜態功耗幾乎為0
然而,實際上由于工藝問題,芯片上總會有微小的漏電,特別是先進工藝如7nm以下的芯片制成,這個漏電會更加嚴重,漏電產生的原因如下:
(1)亞閾值電流(Subthreshold Leakage)
- NMOS/PMOS在**理論"關斷"*時,實際上還是有*微小導通 ? 因為MOS管的閾值并不是硬開硬關
(2)二極管反向漏電
- MOS管的漏極/源極和襯底之間,會形成PN結,PN結反向偏置時,也會有少量漏電流
(3)柵氧化層漏電
- 現代工藝柵氧層超薄(特別是7nm、5nm以下),電場一高 ? 電子會穿隧 ? 也有漏電流
動態電流
然而,上述是指芯片在靜態的情況下的漏電流。當芯片在工作的時候,芯片內部的電流會增大,這主要是由于芯片內部的寄生電容開始放電導致的。
在芯片中,每個mos管和連線都會物理上帶有電容,這是無法避免的。這些電容主要來自MOSFET 柵極和漏/源極之間 , 天然就有電容結構,還有金屬連線之間的電容,金屬層和層之間(M1對M2、M3…)也像電容板,而芯片工作時的電平反轉,其實就是給這些寄生電容充電/放電。
信號翻轉時(比如0 ? 1),電容要充電**(芯片內部線長有電容),翻轉瞬間 ? PMOS和NMOS都短時間同時導通,這時候就會產生瞬時電流,從VDD ? GND這就是動態功耗
動態功耗的公式:
? P=CV2f
其中P代表動態功耗,C代表電容,V代表電壓,f代表工作頻率。
電容代表芯片的電容負載,反映芯片的大小和復雜度,電壓代表芯片電壓,即電源電壓,頻率代表芯片的工作頻率,即芯片每秒處理的指令數。
從公式可以看出,如果電容和電壓增大,動態功耗也會增大:如果頻率增大,動態功耗也會增大。因此,減小芯片的電容、電壓和頻率是減小動態功耗的關鍵
芯片測試中是如何測試靜態和動態電流的?
各類電流測試
| 測試項 | 作用 | 測試時機 | 從CMOS原理解釋 |
|---|---|---|---|
| IDDQ | 靜態電流測試 (Quiescent IDD) | 芯片靜態時 | 檢查有沒有短路、漏電。CMOS靜態時電流應接近0 |
| IDD | 工作電流測試 | 芯片運行時 | 邏輯翻轉時,電容充放電 ? 電流上升 |
| IDDT | 動態電流測試 (Transient IDD) | 芯片特定激勵時 | 電流波動,檢測信號是否在切換 |
| Leakage | 漏電測試 | 電源腳或IO腳 | MOSFET柵氧穿透、電源腳短路、芯片損壞時 ? 漏電流升高 |
IDDQ —— 靜態電流測試(最經典的失效檢測法)
作用:
- 檢查芯片內部有沒有短路、泄漏路徑
- 傳統CMOS邏輯靜態時,IDDQ應為幾微安或幾十微安
- 如果測到mA級別 ? 說明有短路、漏電
從CMOS原理看:
- CMOS的靜態電流 ≈ 漏電流(次級路徑)
- 如果有某個短路缺陷,比如:
- Nmos和Pmos 都導通 ? 電源直接拉通 ? 電流暴漲
ATE設置:
| 參數 | 說明 | 典型設定 |
|---|---|---|
| VDD Supply | 供電電壓 | 0.8V ~ 1.2V(核心) |
| Force Pattern | 特定靜態邏輯Pattern | 全0或全1,或Scan鏈特殊值 |
| Measure Range | uA ~ mA級別 | |
| Limit | 設定上限 | 如 IDDQ < 100uA |
IDD —— 正常工作時的電源電流
作用:
- 測試芯片在正常運作時,總功耗是否在預期范圍
- IDD變化 ? 反映芯片內部邏輯是否在運行
從CMOS原理看:
- 芯片運行時 ? 信號翻轉 ? 電容充放電
- 功耗P = C × V2 × f ? 電流跟頻率直接相關
- 頻率升高 ? 電流增加
- 負載電容大 ? 電流也大
常用于:
- 功耗敏感芯片(手機SoC、IoT)
- 檢查芯片有沒有「鎖死」、「時鐘丟失」之類的失效
- 比如:芯片跑起來 ? IDD從10mA變成30mA ? 說明邏輯活動正常
- 如果ID不變 ? 可能芯片沒跑動
ATE設置:
| 參數 | 說明 | 典型設定 |
|---|---|---|
| VDD Supply | 供電電壓 | 0.8V ~ 1.2V |
| Run Pattern | 向芯片加載Scan Shift/邏輯Pattern | 動態Pattern,如Scan shift 1000 cycles |
| Measure Range | mA ~ 幾百mA | |
| Limit | 設定動態功耗上下限 | 如 10mA < IDD < 30mA |
IDDT —— 動態電流檢測(專門檢測「信號活動」)
作用:
- 通過觀察電流波動,檢測芯片內部信號是否有切換
- 可以間接檢測時鐘、數據鏈是否活躍
從CMOS原理看:
- 動態電流 ? CMOS電容充放電導致
- 如果某個時鐘鏈死了 ? 該部分電流下降 ? IDDT變低
常用于:
-
Scan鏈檢測:看Scan Shift時,IDDT是否如預期波動
-
時鐘鏈檢測:時鐘失效 ? IDDT波動消失
IDD 和IDDT 一般區別不大。
Leakage —— 漏電流檢測(最基礎電流檢測)
作用:
- 檢查芯片IO腳、電源腳有沒有異常漏電
- 比如:芯片Pad與地/電源短路,或者ESD損壞
從CMOS原理看:
- MOS管有亞閾值電流、隧穿電流
- ESD損傷時 ? 短路路徑形成 ? 漏電升高
ATE設置:
| 參數 | 說明 | 典型設定 |
|---|---|---|
| Force Voltage | 施加的電壓 | 0.8V ~ 1.2V(核心電壓),或2.5V、3.3V(IO電壓) |
| Measure Range | 測量電流范圍 | nA ~ uA級別 |
| Limit (Pass/Fail) | 電流門限判斷 | 比如 Leakage < 1uA 為Pass |
良品芯片:Leakage通常在幾十nA~幾百nA
壞品芯片:Leakage達到uA甚至mA ? 短路或損傷
tips:關于芯片制程和IDDQ以及IDD的關系
芯片制程越先進,動態 電流越小,靜態 電流越大
| 功耗類型 | 制程變小(例如從28 nm→7 nm→5 nm) | 原因 |
|---|---|---|
| 動態功耗 | 減小 | 電容 C 更小,工作電壓 V 也更低 → Pdynamic=C·V2·f↓ |
| 靜態功耗 | 增大 | 柵氧層超薄、閾值電壓降 → 漏電流(亞閾值、隧穿)飆升 |


)






)
)

)




)

