知識點14:
MOSFET的電容主要來源于其物理結構:
- 柵氧層電容:柵極(G)與襯底(B)、溝道、源(S)、漏(D)之間隔著二氧化硅絕緣層,自然形成電容。
- 耗盡層電容:在半導體內部,耗盡區(缺少自由載流子的區域)也像一個電容器的介質。
- ?overlap電容:柵極與源/漏區有部分重疊,形成固定的覆蓋電容。
這些電容不是固定的,其大小和連接方式強烈依賴于柵極電壓(V_GS),因為它決定了硅表面是積累、耗盡還是反型。
Case I: 積累區 (Accumulation)
- 偏置條件:
 ?< 0?(柵極加負電壓)
?< 0?(柵極加負電壓) - 物理狀態:柵極的負電壓排斥P型襯底中的電子,同時吸引大量的帶正電的空穴到柵氧層下方的表面區域。這些空穴密集地堆積起來,形成所謂的“積累層”。
- 電容構成(見下圖一):
 ?(柵-襯底電容):這是最主要的電容。積累層的空穴形成了一個優秀的導體下極板,與柵極(上極板)之間的電容完全由柵氧層決定,其單位面積電容達到最大值
?(柵-襯底電容):這是最主要的電容。積累層的空穴形成了一個優秀的導體下極板,與柵極(上極板)之間的電容完全由柵氧層決定,其單位面積電容達到最大值  。
。
其中:![]()
![]() :柵氧層(二氧化硅SiO?)的介電常數
:柵氧層(二氧化硅SiO?)的介電常數
![]() :柵氧層的厚度
:柵氧層的厚度
由本式可知:電容值與介電常數成正比,與介質厚度成反比。
總電容值為:

![]() : 繪制溝道長度。是芯片設計版圖上畫的柵極多晶硅的長度
: 繪制溝道長度。是芯片設計版圖上畫的柵極多晶硅的長度
![]() : ?橫向擴散長度。在制造過程中,源和漏區的摻雜原子會橫向擴散,稍微延伸到柵極下方,導致實際的溝道長度比繪制的要短
: ?橫向擴散長度。在制造過程中,源和漏區的摻雜原子會橫向擴散,稍微延伸到柵極下方,導致實際的溝道長度比繪制的要短
![]() ?有效溝道長度
?有效溝道長度![]() 。它是柵極真正覆蓋在溝道區域上的長度,是計算本征柵電容的有效長度
。它是柵極真正覆蓋在溝道區域上的長度,是計算本征柵電容的有效長度
![]() :繪制溝道寬度。是版圖上畫的柵極的寬度
:繪制溝道寬度。是版圖上畫的柵極的寬度
![]() :?比例因子平方。在電路仿真中,為了方便,經常使用單位尺寸的模型。scale?是一個縮放因子,表示當前器件的尺寸是單位器件的多少倍。因為面積是二維的,所以電容(與面積成正比)需要乘以?scale?的平方
:?比例因子平方。在電路仿真中,為了方便,經常使用單位尺寸的模型。scale?是一個縮放因子,表示當前器件的尺寸是單位器件的多少倍。因為面積是二維的,所以電容(與面積成正比)需要乘以?scale?的平方
由本式可知:在積累區,整個溝道區域(面積 =![]() ?*
?* ![]() )都形成了平板電容結構。因此,總電容?
)都形成了平板電容結構。因此,總電容?![]() 就等于單位面積電容?
就等于單位面積電容?![]() ?乘以有效柵面積?(
?乘以有效柵面積?(![]() ?*
?* ![]() ),再乘以尺寸縮放因子?
),再乘以尺寸縮放因子?![]() 。
。
 ?和
?和  ?(覆蓋電容):這是柵極與源/漏擴散區重疊部分形成的固定電容,
?(覆蓋電容):這是柵極與源/漏擴散區重疊部分形成的固定電容, 。它們始終存在,與偏壓無關。
。它們始終存在,與偏壓無關。
其中:![]() ,
,![]() ?是柵-源和柵-漏覆蓋電容。它們的大小通常相等。
?是柵-源和柵-漏覆蓋電容。它們的大小通常相等。
由本式可知:由于制造過程中的橫向擴散,柵極不可避免地會與源區和漏區有一小部分重疊。這個重疊區域也形成了一個平板電容器(柵極是上極板,重摻雜的源/漏區是下極板)。因此,每個覆蓋電容的大小等于![]() ?乘以重疊面積?(
?乘以重疊面積?(![]() )。這是一個寄生電容,對電路的高速性能(如速度、延時)有重要影響
)。這是一個寄生電容,對電路的高速性能(如速度、延時)有重要影響
- 關鍵問題 - 寄生電阻:雖然
 的電容值很大,但這個電容的“下極板”(積累層)是通過電阻率很高的襯底連接到電路的地電位的。下圖一中標注的“Resistance to the substrate connection”就是這個巨大的寄生電阻(Rs)。這個電阻會嚴重惡化電容的高頻性能,使其充放電速度變慢。
的電容值很大,但這個電容的“下極板”(積累層)是通過電阻率很高的襯底連接到電路的地電位的。下圖一中標注的“Resistance to the substrate connection”就是這個巨大的寄生電阻(Rs)。這個電阻會嚴重惡化電容的高頻性能,使其充放電速度變慢。 - 結論:在積累區,電容大但質量差,是?“壞電容”?(對應下圖一左側“Bad cap area”)。
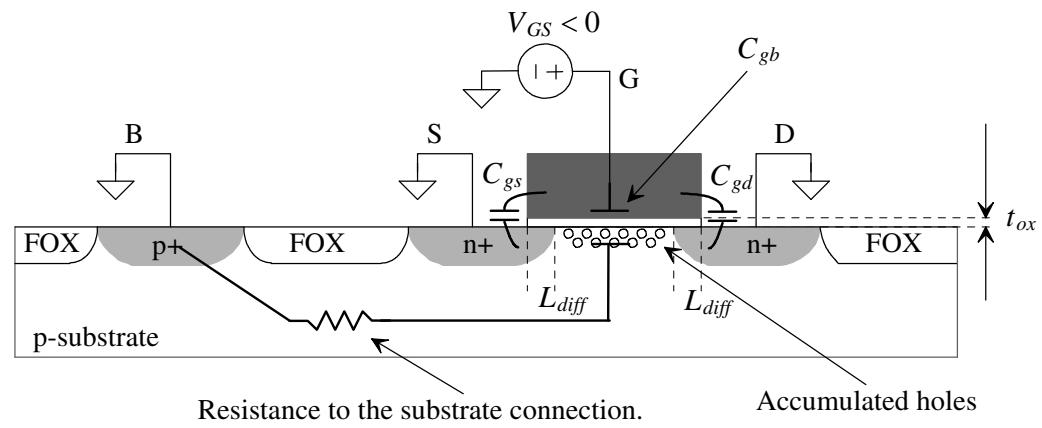
圖一 MOSFET工作在累積模式下的橫截面圖
Case II: 耗盡區 (Depletion/Weak Inversion)
- 偏置條件:0 <
 ?<?
?<? ?(柵極加正電壓,但不足以形成強反型)
?(柵極加正電壓,但不足以形成強反型) - 物理狀態:柵極的正電壓開始排斥P型襯底中的空穴,在表面下方留下一個由不可移動的帶負電的受主離子組成的區域,這個區域缺乏自由載流子,稱為?“耗盡層”?。此時表面沒有形成導電溝道。
- 電容構成(見下圖二):
- 此時的柵極到襯底的路徑不再是簡單的柵氧電容。可以將其建模為兩個電容的串聯:
- 柵氧電容 (
 )
) - 耗盡層電容 (
 )
)
- 柵氧電容 (
- 隨著
 增大,耗盡層變寬(相當于電容器極板距離增加),
增大,耗盡層變寬(相當于電容器極板距離增加), 減小,導致總電容
減小,導致總電容 進一步減小。這就是圖三中間那段下降曲線的原因。
進一步減小。這就是圖三中間那段下降曲線的原因。  ?和
?和  :仍然是固定的覆蓋電容。
:仍然是固定的覆蓋電容。
- 此時的柵極到襯底的路徑不再是簡單的柵氧電容。可以將其建模為兩個電容的串聯:
- 結論:在耗盡區(弱反型區),總柵電容下降,其值由耗盡層寬度調制。
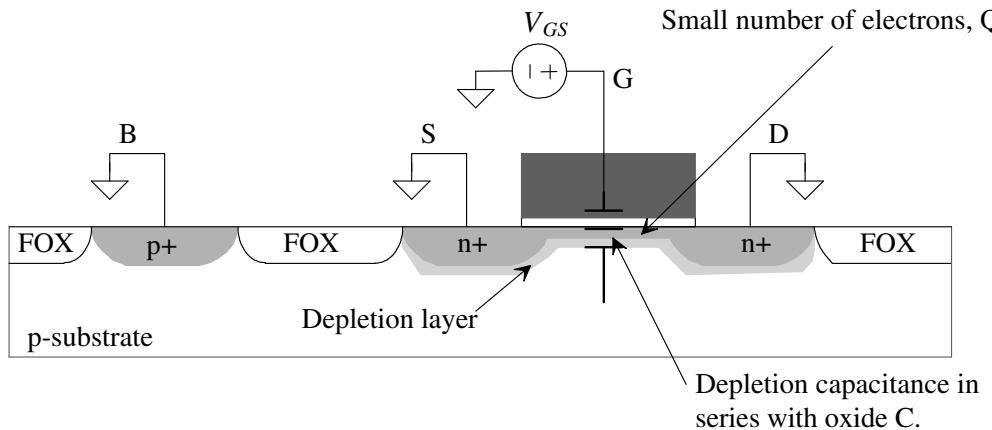
圖二 耗盡型MOSFET的截面圖
Case III: 強反型區 (Strong Inversion)
- 偏置條件:
 >>
>>  ?(柵極加足夠大的正電壓)
?(柵極加足夠大的正電壓) - 物理狀態:柵極的強正電場吸引了大量電子到表面,形成一個濃厚的n型反型層(溝道),將源和漏連接起來。這個電子層就像一個高導電的金屬板。
- 電容構成:
 ?(柵-襯底電容):此時,高導電的反型層屏蔽了襯底,成為了電容新的“下極板”。這個下極板通過低電阻的源/漏區連接到外部電路。因此,電容值再次達到最大值?
?(柵-襯底電容):此時,高導電的反型層屏蔽了襯底,成為了電容新的“下極板”。這個下極板通過低電阻的源/漏區連接到外部電路。因此,電容值再次達到最大值? ,并且其串聯電阻極小。
,并且其串聯電阻極小。 ?和
?和  :仍然是固定的覆蓋電容。
:仍然是固定的覆蓋電容。
- 結論:在強反型區,電容值大且串聯電阻小,是?“好電容”?(對應下圖三右側“Good cap area”)。集成電路中常用工作在強反型區的MOSFET(將源、漏、體端子短路)來制作精確的電容。

圖三 柵電容隨直流柵源電壓的變化
總結
歸一化柵電容隨![]() 變化的整體趨勢:從高(積累) -> 下降(耗盡) -> 再回到高(強反型)。當你需要一個大電容時,應優先選擇讓MOSFET工作在強反型區,以獲得最佳性能。如果必須在積累區使用(在某些特殊工藝或電路中),必須意識到巨大的寄生電阻問題,并在器件周圍放置大量襯底接觸(Contacts)?來盡可能降低這個電阻。
變化的整體趨勢:從高(積累) -> 下降(耗盡) -> 再回到高(強反型)。當你需要一個大電容時,應優先選擇讓MOSFET工作在強反型區,以獲得最佳性能。如果必須在積累區使用(在某些特殊工藝或電路中),必須意識到巨大的寄生電阻問題,并在器件周圍放置大量襯底接觸(Contacts)?來盡可能降低這個電阻。



)
)






 -- 網卡隊列)



之加載Mapper)


