知識點8:
離子注入是為了將摻雜劑(如硼、磷等)精確引入硅晶片的近表面區域,以改變其電學性質。
工藝過程:
- 電離與加速:摻雜劑原子在離子源中被電離(帶電),通過高壓電場(幾千伏至百萬伏)加速,形成高能離子束。
- 轟擊與注入:高能離子轟擊硅片表面并嵌入晶格中。
- 晶格損傷與修復:離子注入會導致硅晶格損傷,需通過后續高溫退火修復,同時激活摻雜劑(使其占據晶格位置并發揮電學作用)。
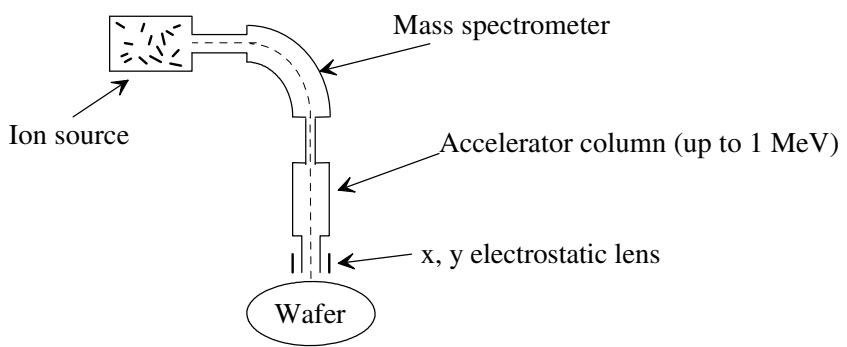
離子交換器簡圖
圖中:
- 離子源:通過射頻(RF)場產生離子。
- 質譜儀:篩選特定質量的離子(確保純度)。
- 加速器:離子經高壓加速。
- 靜電透鏡:掃描離子束至晶圓表面,控制劑量均勻性。
注入摻雜分布模型的數學描述:

 :深度x處的摻雜濃度。
:深度x處的摻雜濃度。 :峰值濃度(最大摻雜濃度)。
:峰值濃度(最大摻雜濃度)。 ?:投影射程(離子平均穿透深度,比如大部分離子停在硅片下0.1微米處)。
?:投影射程(離子平均穿透深度,比如大部分離子停在硅片下0.1微米處)。- Δ
 ??:離散參數(離子分布的標準偏差,反映濃度分布的寬度,數值越大,說明有的離子鉆得深,有的鉆得淺)。
??:離散參數(離子分布的標準偏差,反映濃度分布的寬度,數值越大,說明有的離子鉆得深,有的鉆得淺)。
通俗的話來解釋:就像往沙堆里扔一把彈珠:大部分彈珠停在某個深度(![]() ??),這里彈珠最密集(
??),這里彈珠最密集(![]() ?)。但有些彈珠彈得遠,有些彈得近(Δ
?)。但有些彈珠彈得遠,有些彈得近(Δ![]() ??決定分散程度)。整體分布是一個“鐘形曲線”(高斯分布)。
??決定分散程度)。整體分布是一個“鐘形曲線”(高斯分布)。

圖中顯示理想的植入體輪廓分布,即分布模型所示
上圖可見:
- 濃度峰值位于表面下方Rp?處,呈高斯分布。
- 注入能量越高,Rp越大(離子穿透更深)
劑量計算數學公式:
![]()
![]() 為總注入劑量(單位面積離子數)。
為總注入劑量(單位面積離子數)。
簡單說就是把硅片切成無數薄片,數每一片里的離子,最后全部加起來。相當于統計“總共扔了多少顆彈珠到沙堆里”。
掩膜的使用:
- 局部注入:通過掩模(如氧化物、光刻膠)阻擋離子,僅在暴露區域注入。
- 掩模厚度要求:必須足夠厚以完全阻擋離子到達硅襯底。
- 對比擴散工藝的優勢:
- 低溫工藝:避免高溫對器件的熱影響。
- 精確控制:通過調節能量和劑量,可精準控制摻雜濃度與深度。















)
網絡層 IPv4、CIDR(使用子網掩碼進行網絡劃分)、NAT在私網劃分中的應用)

