來源:A Compact Model of High-Voltage MOSFET Based on Electric Field Continuity for Accurate Characterization of Capacitance(TED 24年)
摘要
本文提出了一種新的高壓MOSFET(HV MOS)緊湊模型,以消除現有模型中過高電容峰值的問題。與現有的改進電容模型方法相比,所提出的模型不再基于內部MOS和漂移區模型之間的電流連續性,而是基于電場連續性,并考慮了由于屏蔽柵(SG)和接觸場板(CFP)引起的漂移區的二維效應。引入了一個新的遠離SiO2/Si界面的點Ki,并使用點Ki處的靜電勢ψKi來替代內部漏極電壓VK作為內部MOS的漏極電壓,用于計算電流和電荷。此外,我們不再使用大多數現有模型中用于獲取柵-漏極重疊(GDO)區域表面靜電勢ψK的一維高斯方程,而是提出了一個考慮P-區/ N-漂移結影響的新ψK模型。所提出的模型利用MM11模型來描述內部MOS的電流和電荷,并結合了作為ψK函數的GDO區域電荷模型,可以有效消除過高的電容峰值,并準確捕捉HV MOS的直流和電容特性。
關鍵詞:2D效應、緊湊模型、電場連續性、柵-漏極重疊(GDO)區域電荷、高壓MOSFET(HV MOS)
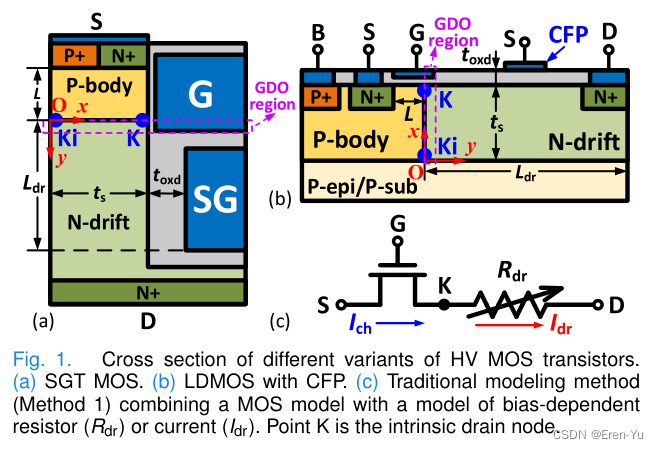
文章的研究內容
文章的研究內容是提出了一種新的高壓MOSFET(HV MOS)緊湊模型,該模型基于電場連續性來精確表征電容特性。與現有改進的電容模型方法相比,此模型不再依賴于內在MOS與漂移區模型之間的電流連續性,而是考慮了由屏蔽柵(SG)和接觸場板(CFP)引起的漂移區的二維效應。研究中引入了一個遠離SiO2/Si界面的新點Ki,并使用Ki點處的靜電勢ψKi來替代內在MOS的漏極電壓VK,進而計算電流和電荷。此外,研究沒有采用多數現有模型中使用的基于一維高斯方程來獲取柵-漏重疊(GDO)區域的表面靜電勢ψK,而是提出了一種新的ψK模型,該模型考慮了P體/N-漂移結界面對ψK的影響。
文章所提出的模型利用MM11模型來描述內在MOS的電流和電荷,并結合考慮ψK影響的GDO區域電荷模型,能夠有效消除過高的電容尖峰,精確捕捉HV MOS的直流和電容特性。研究還通過使用二維泊松方程來求解ψKi,并提出了一種非迭代方法來計算ψKi,從而提高了計算速度和魯棒性。通過與技術計算機輔助設計(TCAD)模擬結果以及15伏LDMOS的實際測量數據對比,驗證了模型的有效性和準確性。模型還納入了熱網絡以考慮自熱效應,盡管實驗條件限制使得無法獲取所有VDS下的CGG曲線,但模型能準確捕捉CGD-VDS曲線的尖峰。
文章的核心貢獻是開發了一個新的緊湊模型,它通過創新的電場連續性概念和對漂移區二維效應的考慮,顯著改善了高壓MOSFET電容特性的模擬精度。
文章的研究方法
文章采用的研究方法主要集中在理論建模、數值分析和實驗驗證幾個方面,具體包括:
-
理論建模與創新:研究團隊提出了一種新型的高壓MOSFET(HV MOS)緊湊模型,該模型基于電場連續性而非傳統電流連續性原理,這是理論創新之處。模型設計時考慮了二維(2-D)效應,特別是由屏蔽柵(SG)和接觸場板(CFP)結構引起的漂移區效應。模型中引入了一個新的變量點Ki,用Ki點處的靜電勢ψKi代替傳統的漏極電壓VK來計算內在MOS的電流和電荷,這有助于更精確地表征高壓MOS器件的電容特性。
-
數值求解與參數優化:研究中利用二維泊松方程求解ψKi,并通過數學推導與近似方法,如泰勒級數展開,得到了一系列方程來描述不同工作區間的電壓和電荷關系。同時,提出了一個非迭代方法來快速且穩定地計算ψKi,以提高計算效率。模型中涉及的參數(如θch、θc、θd、kvg0、kvg1等)通過理論分析和擬合確定,以確保模型的精確度和實用性。
-
與現有方法對比:通過與現有的幾種方法(稱為方法1至3)進行對比,文章展示了新模型在消除過高電容尖峰方面的優勢,特別是在精確捕獲高壓MOS器件的直流和電容特性方面。這種對比分析是通過理論推導和數值仿真完成的。
-
技術計算機輔助設計(TCAD)仿真驗證:研究團隊利用成熟的TCAD軟件進行了仿真,驗證了所提模型在18伏LDMOS器件上的適用性和準確性,包括直流特性和電容特性。仿真結果表明,新模型能夠準確預測并消除電容尖峰現象。
-
實驗數據驗證:除了仿真驗證,文章還利用了15伏LDMOS的實際測量數據進一步驗證模型的準確性,證明模型不僅能有效應用于仿真環境,也能很好地反映真實器件的行為。
-
模型參數調整與優化:通過對模型參數的細致調整,確保模型能夠適應不同條件下的器件特性,體現了模型的靈活性和普適性。
研究結合了理論分析、數值模擬與實驗驗證等多種研究方法,旨在開發并驗證一種能夠準確表征高壓MOSFET電容特性的創新緊湊模型。
文章的創新點
文章的創新點在于提出了一種新的高壓MOSFET(HV MOS)緊湊模型,旨在解決現有模型中電容尖峰過高的問題。以下是幾個關鍵創新點:
-
基于電場連續性的新方法:不同于以往基于電流連續性的模型,新模型側重于電場連續性,更準確地處理了高壓MOS器件中漂移區的二維效應。這得益于考慮了屏蔽柵(SG)和接觸場板(CFP)對漂移區的二維影響,使用了二維泊松方程來描述漂移區的電場分布。
-
引入Ki點和ψKi參數:模型創新性地引入了遠離SiO2/Si界面的新點Ki,并使用該點的電勢ψKi替代傳統的內在漏極電壓VK,來計算電流和電荷。ψKi的使用不僅避免了復雜的Maxwell-Boltzmann統計結合,而且簡化了模型復雜度,提高了計算速度和模型的穩健性。
-
非迭代計算ψKi:為提升計算效率,文章提出了一個非迭代計算ψKi的方法,這在處理復雜物理現象時特別有益,因為通常迭代計算過程可能較為緩慢且穩定性不佳。
-
改進的ψK模型:針對柵-漏重疊(GDO)區域的電荷模型,文章提出了一種新的ψK模型,該模型考慮了P體/N-漂移結界面對ψK的影響,從而克服了傳統模型僅使用一維高斯方程忽略二維效應的局限性。
-
綜合MM11模型應用:模型綜合運用了MM11模型來描述內在MOS的電流和電荷特性,并將GDO區域的電荷模型與之結合,實現了對HV MOS器件的直流特性和電容特性準確的描述,有效消除了電容尖峰問題。
-
理論與實踐結合驗證:研究不僅在理論上構建了模型,還通過技術計算機輔助設計(TCAD)仿真和實際15伏LDMOS器件的測量數據進行了驗證,證明了模型的有效性和準確性,體現了理論與實踐的緊密結合。
這些創新點共同構成了一個更為精準、高效且實用的高壓MOSFET電容特性描述模型,對高壓集成電路的設計與優化具有重要意義。
文章的結論
文章的結論是,為了消除高壓MOSFET(HV MOS)中現存模型表現出的過度電容尖峰問題,本文提出了一種基于電場連續性的新型緊湊模型。該模型創新性地考慮了由屏蔽柵(SG)和接觸場板(CFP)引起的漂移區二維效應,并引入了一個遠離SiO2/Si界面的點Ki,利用該點的電勢ψKi代替傳統的內在MOS漏極電壓VK來計算電流和電荷。此外,模型摒棄了常用的沿通道方向的一維高斯方程來獲取GDO區域的表面電勢ψK,而是提出了一個新的ψK模型,該模型考慮了P體/N-漂移結界面對ψK的影響。
模型的核心組成部分包括MM11模型來模擬內在MOS的電流和電荷,以及基于ψK的GDO區域電荷模型。這些組件的整合有效地去除了電容尖峰現象,并精確地捕捉了HV MOS的直流特性和電容特性。TCAD仿真結果和15V LDMOS的實際測量數據均被用來驗證模型的準確性,表明模型在預測和表征高壓MOS器件的電容特性方面具有顯著的優勢。
為了提高計算速度和模型的穩健性,文中還提出了一種非迭代方法來計算ψKi。最后,模型中加入了熱網絡以實現自熱效應的模擬,盡管受限于實驗條件,無法獲取不同VDS下的CGG曲線,但模型能精確捕捉CGD-VDS曲線的尖峰。
總之,本文提出的基于電場連續性的高壓MOSFET緊湊模型成功解決了電容尖峰問題,提高了電容特性的預測精度,并通過理論分析、仿真驗證和實測數據的綜合評估,驗證了其在HV MOS器件建模中的有效性和實用性。














)




