01
一、碳化硅晶體材料中的缺陷到底是什么?
碳化硅晶體材料中的缺陷是指在晶體生長、加工或使用過程中出現的不完美結構。
這些缺陷可能表現為晶體內部的裂紋、表面的凹坑、原子排列的錯誤等。
雖然缺陷看起來微不足道,但它們卻可能對晶體的電學、熱學和機械性能產生重大影響。
例如:
- 電學性能:缺陷會引入額外的電荷陷阱,影響載流子的遷移率和壽命,從而降低器件的開關速度和功率效率。
- 熱學性能:缺陷會導致熱導率降低,影響器件的散熱性能。
- 機械性能:缺陷會降低晶體的強度和韌性,影響器件的可靠性。
02
二、缺陷是如何分類的?
根據國家標準,碳化硅晶體材料的缺陷主要分為四大類:
晶錠缺陷、襯底缺陷、外延缺陷和工藝缺陷。
接下來,我們將逐一介紹每一類缺陷的典型特征及其產生原因。
(一)晶錠缺陷
晶錠是碳化硅晶體生長的初始階段,其質量直接影響后續加工和器件性能。晶錠缺陷主要包括以下幾種:
1.?裂紋
- 特征:晶體內部有貫穿型或部分穿透的裂紋,嚴重時晶體可能碎裂成塊。
- 產生原因:在晶體生長、退火或加工過程中,熱應力過大或機械應力超過晶體耐受閾值,導致晶體開裂。

2.?雜晶
- 特征:晶體內部形成的多晶嵌入式生長,與單晶之間存在明顯襯度界線。
- 產生原因:生長過程中包裹物或生長條件劇烈波動,導致多晶成核長大。

3.?邊緣多晶
- 特征:多晶附著在晶體邊緣,與內部單晶之間存在明顯交界線。
- 產生原因:溫度場分布不合理導致籽晶邊緣升華,或生長初期籽晶處徑向溫度梯度過小。
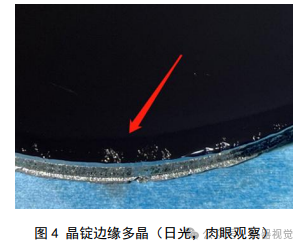
4.?多型
- 特征:晶體中出現6H、15R或3C等異晶型,顏色與4H晶型存在明顯差異。
- 產生原因:偏離4H-SiC生長窗口,或生長表面污染物導致異晶型成核生長。
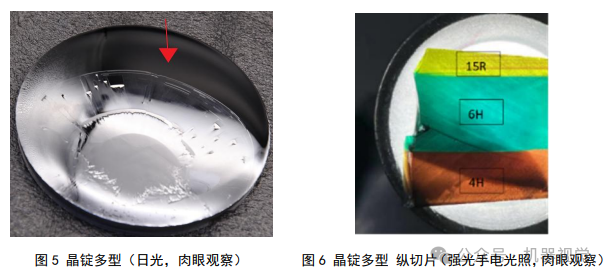
5.?微管
- 特征:微米級直徑的物理孔洞,終端延伸至晶體表面,形成小凹坑。
- 產生原因:多型、碳包裹體、硅滴等因素導致局部應變和晶格畸變。
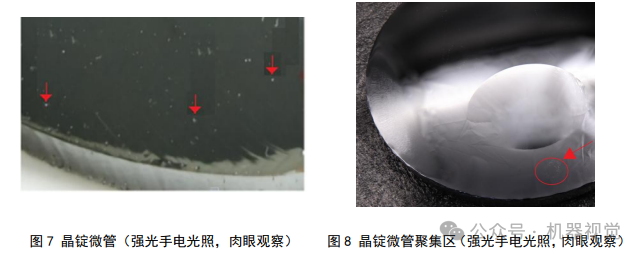
(二)襯底缺陷
襯底是外延生長的基礎,其質量至關重要。襯底缺陷主要包括以下幾種:
1.?多晶
- 特征:多晶與單晶之間存在明顯襯度界線。
- 產生原因:溫度場分布不合理或生長條件劇烈波動。
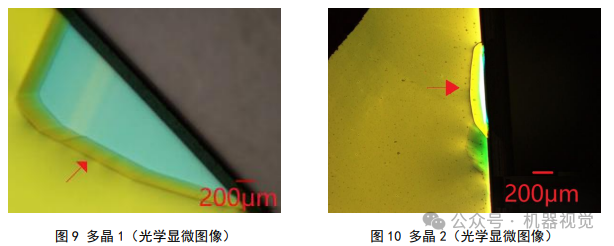
2.?多型
- 特征:晶體中出現6H、15R或3C等異晶型,顏色與4H晶型存在明顯差異。
- 產生原因:偏離4H-SiC生長窗口,或生長表面污染物導致異晶型成核生長。

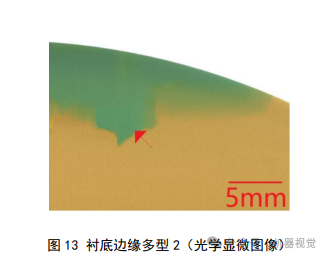
3.?硅滴包裹體
- 特征:液滴形貌的硅組份夾雜。
- 產生原因:生長過程中硅組分分壓過高,形成Si單質顆粒被后續生長的單晶包裹。
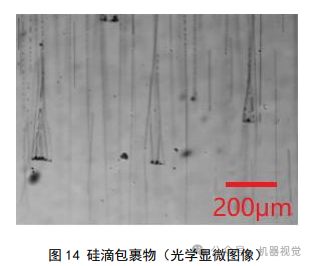
4.?碳包裹體
- 特征:由碳元素組成的固相原子團簇或小顆粒體。
- 產生原因:多晶原料非化學計量比升華或石墨部件腐蝕形成碳顆粒。
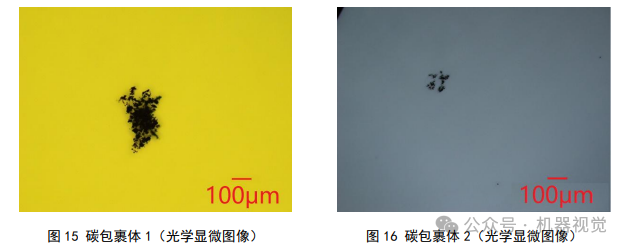
- 5.?六方空洞
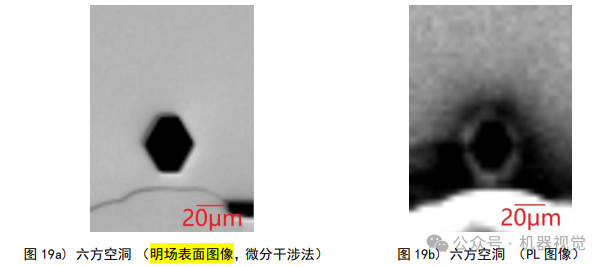
- 特征:六邊形的空腔結構。
- 產生原因:籽晶粘接不良導致籽晶背部負生長。
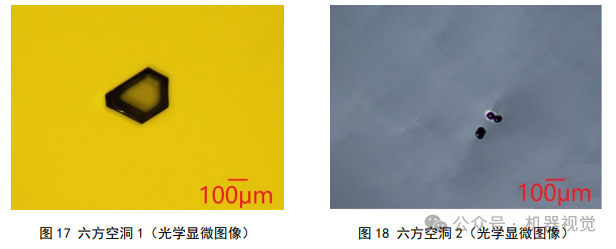
6.?層錯
- 特征:晶面堆疊順序的錯誤,分為Shockley型和Frank型。
- 產生原因:機械應力、溫度分布不均勻或制備籽晶過程中遺留在其表面上的殘余劃痕。
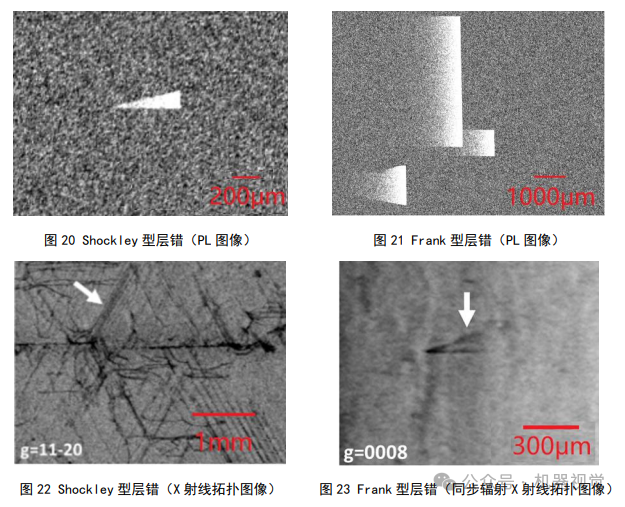
7.?穿透螺位錯
- 特征:蝕坑呈六邊形。
- 產生原因:籽晶中的TSD遺傳至單晶襯底中,或生長過程中引入內應力及應變。
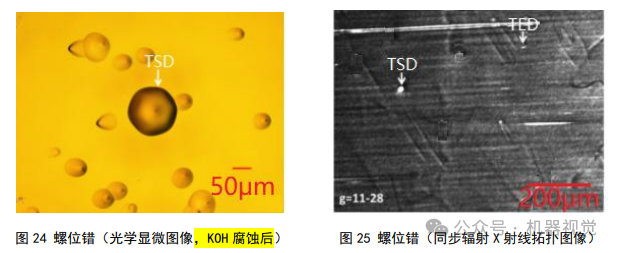
8.?穿透刃位錯
- 特征:蝕坑呈近圓形。
- 產生原因:籽晶中的TED遺傳至單晶襯底中,或生長過程中引入內應力及應變。
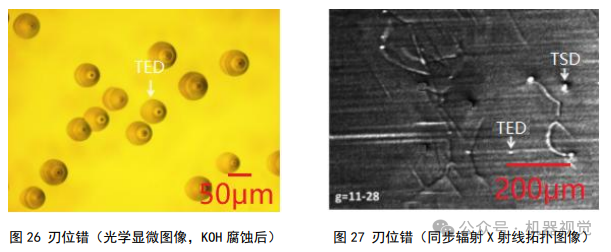
9.?基平面位錯
- 特征:蝕坑呈貝殼狀。
- 產生原因:籽晶中的BPD遺傳至單晶襯底中,或生長過程中引入熱應力和雜質。
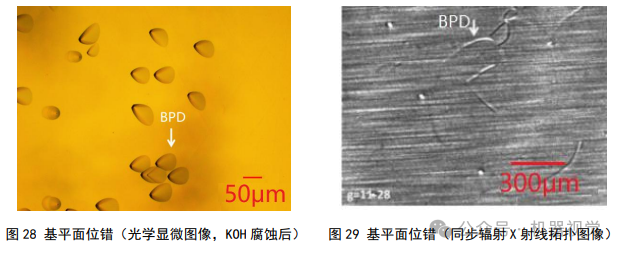
(三)外延缺陷
外延生長是在襯底上形成高質量晶體薄膜的關鍵步驟。

外延缺陷主要包括以下幾種:
1.?掉落顆粒物缺陷
- 特征:孤立出現的大型點狀形貌,或以點狀顆粒物為頭部并伴隨出現三角形形貌。
- 產生原因:反應室內顆粒物掉落在襯底或外延層表面。
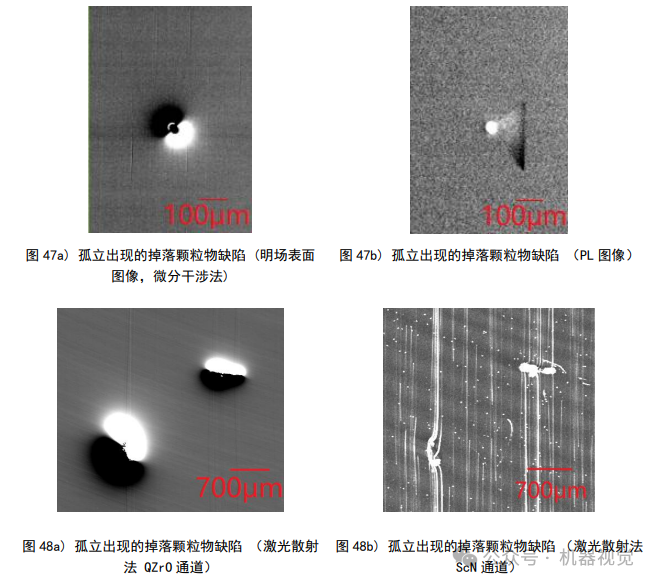
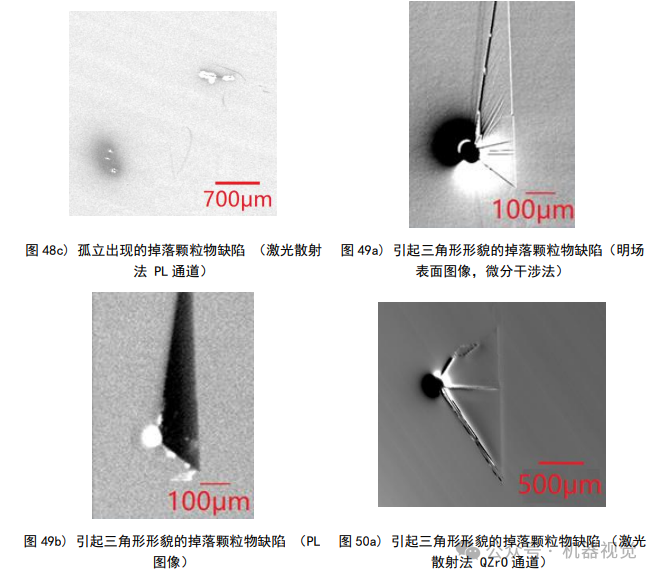

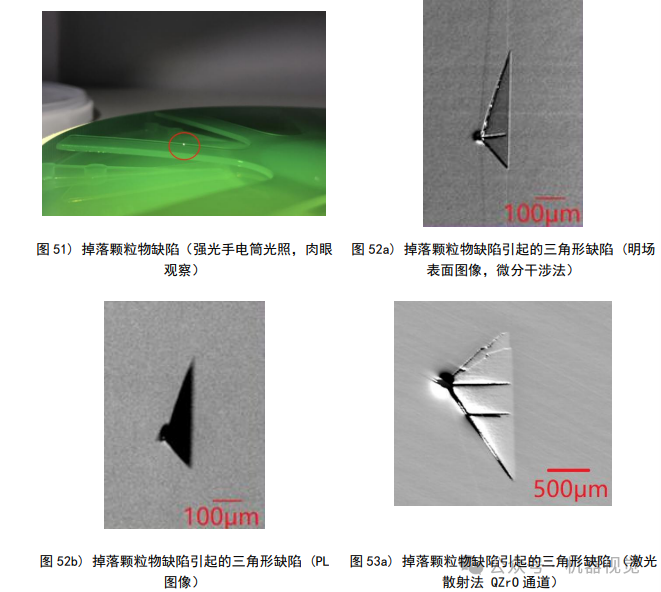
2.?三角形缺陷
- 特征:從基晶面內延伸到外延層表面的三角形圖案。
- 產生原因:掉落顆粒物、乳凸、劃痕或TSD影響原子臺階流動。
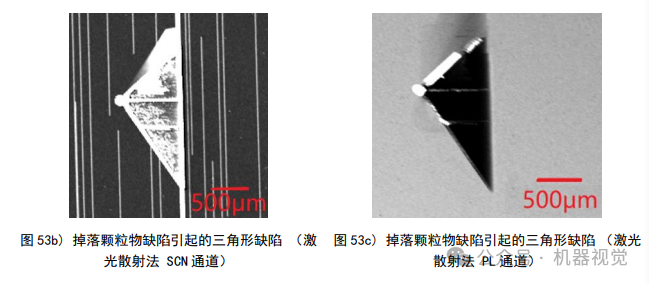
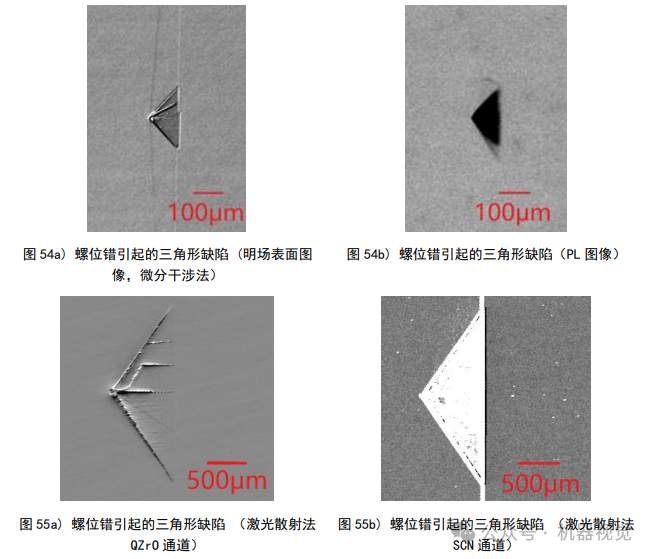
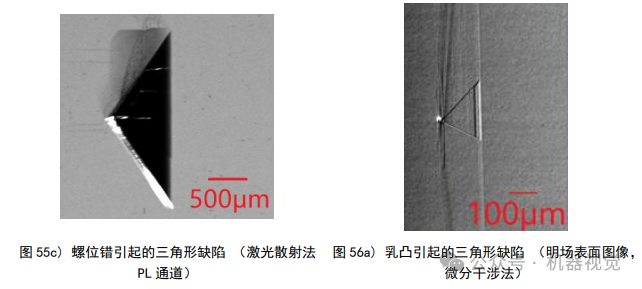
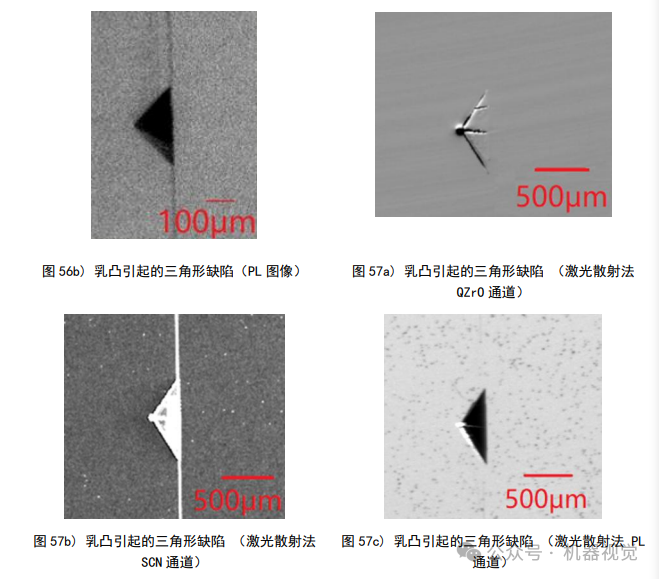
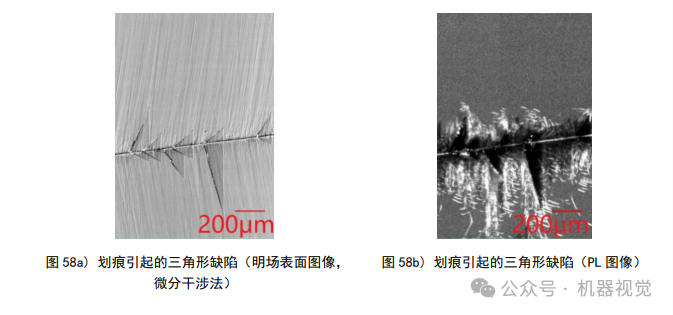
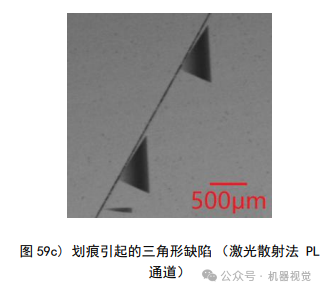
3.?彗星缺陷
- 特征:明場表面圖像和PL圖像中呈現彗星狀圖案。
- 產生原因:外來物影響原子臺階流動,在富硅的外延工藝條件下形成。
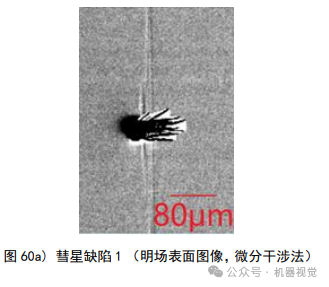
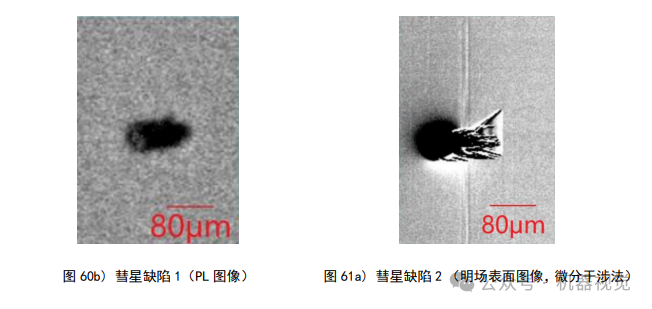
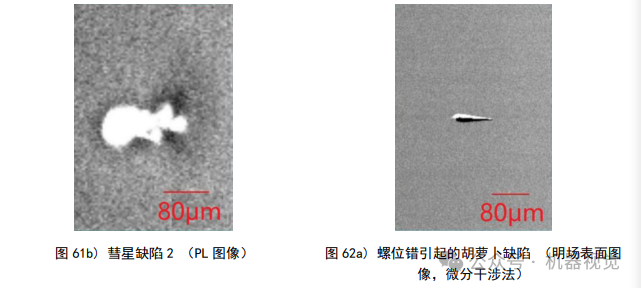
4.?胡蘿卜缺陷
- 特征:明場表面圖像上呈胡蘿卜狀圖案,PL圖像上呈線型圖案。
- 產生原因:襯底中的TSD和表面劃痕引起。
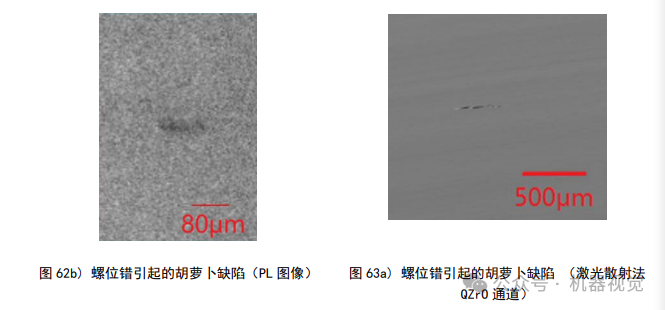
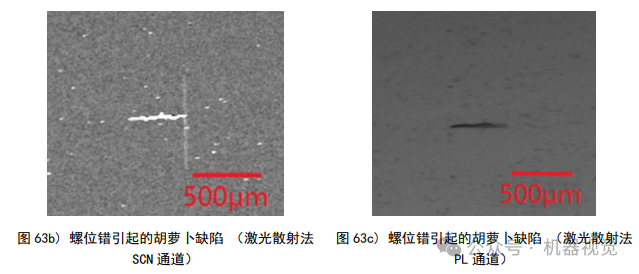
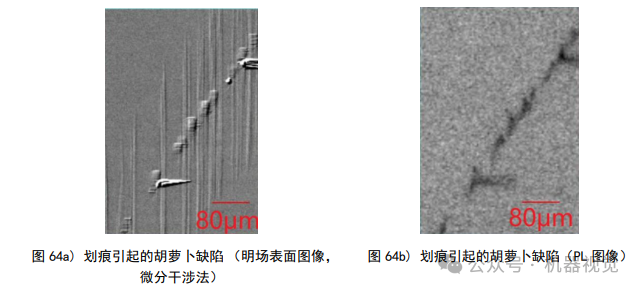
5.?凹坑
- 特征:小凹陷或小坑狀的形貌。
- 產生原因:襯底中的凹坑、TSD和TED貫穿到外延層。
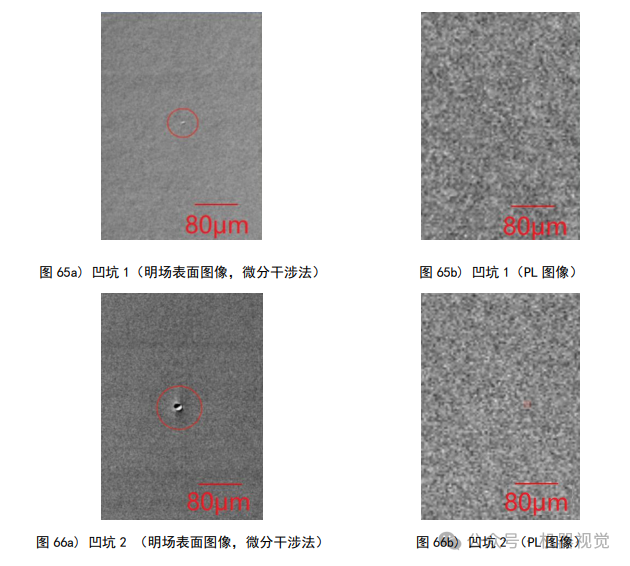
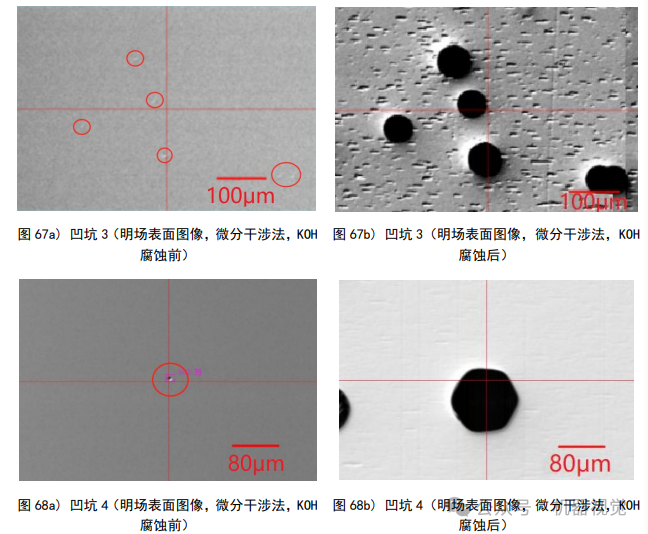
6.?梯形缺陷
- 特征:明場表面圖像上呈梯形狀。
- 產生原因:BPD、TED、TSD和劃痕周圍的位錯環影響原子臺階流動。
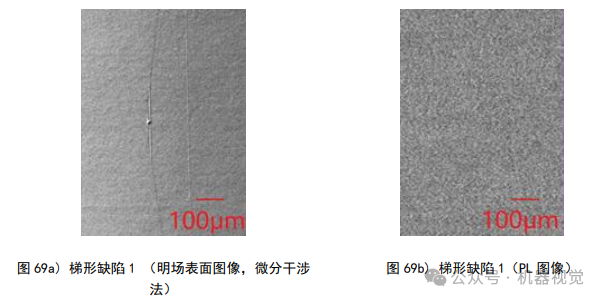
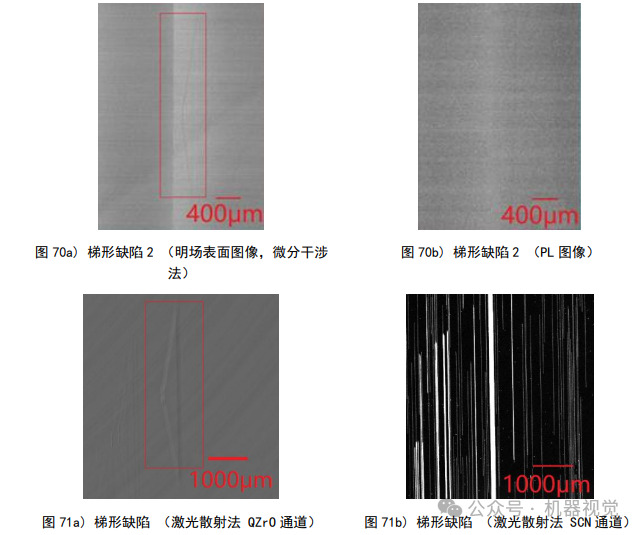
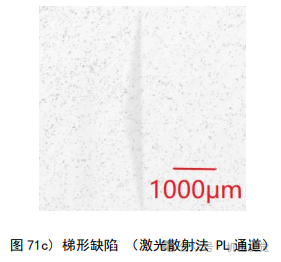
7.?臺階聚集
- 特征:多個原子臺階匯聚在一起形成的平行線簇。
- 產生原因:襯底結晶缺陷或劃痕阻礙原子流動。
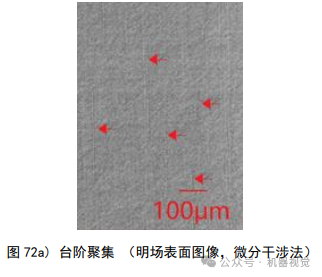
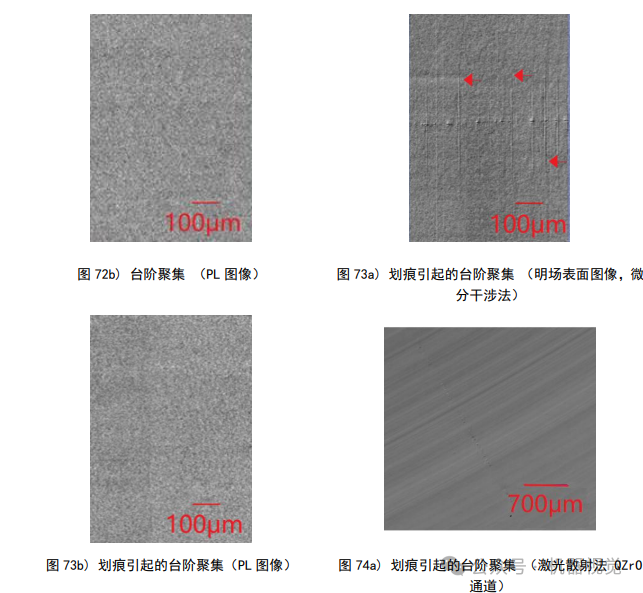
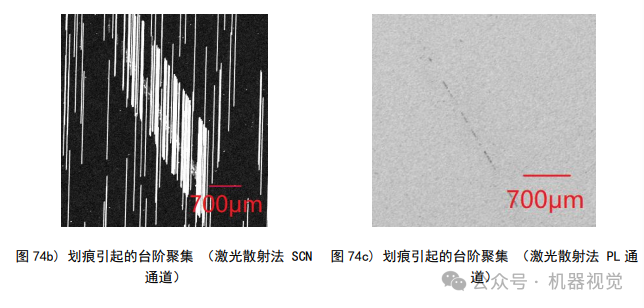
8.?外延凸起
- 特征:晶片邊緣高度凸起。
- 產生原因:晶片邊緣應力引起三角形缺陷團簇。
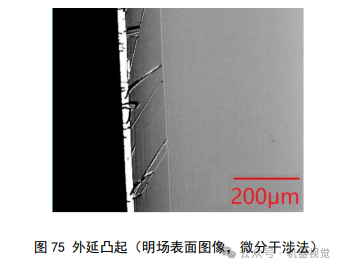
9.?乳凸
- 特征:表面呈現為凸點或凸起狀。
- 產生原因:小尺寸顆粒在外延生長前階段掉落在晶片表面。
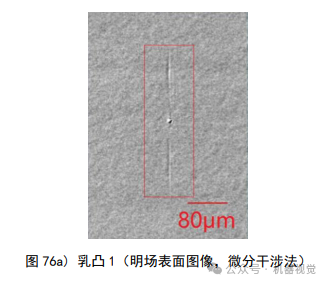
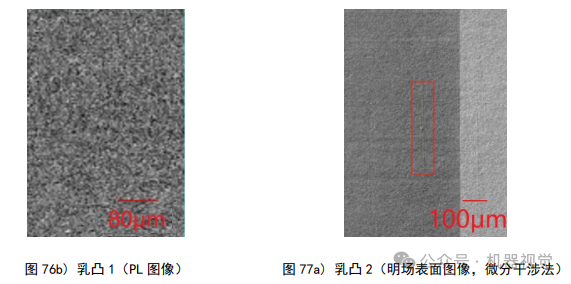
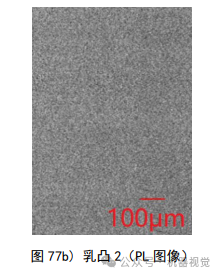
- 10.?微管
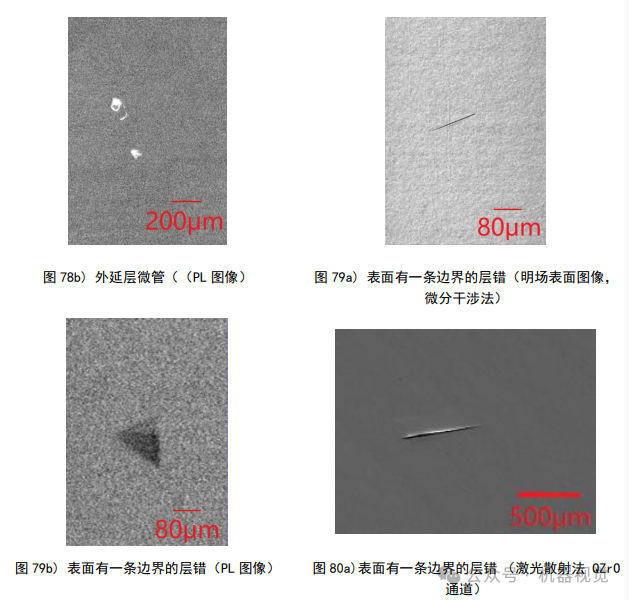
- 特征:明場表面圖像中呈凹坑狀,PL圖像中呈螺旋紋圖案。
- 產生原因:襯底MP貫穿到外延層。
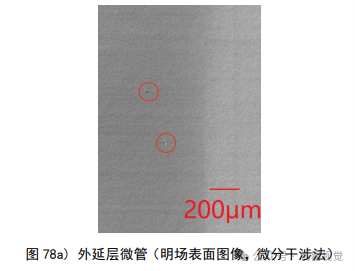
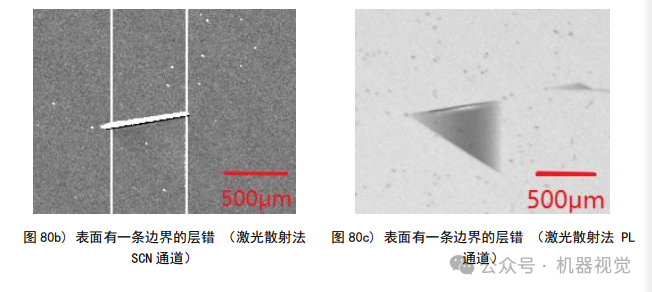
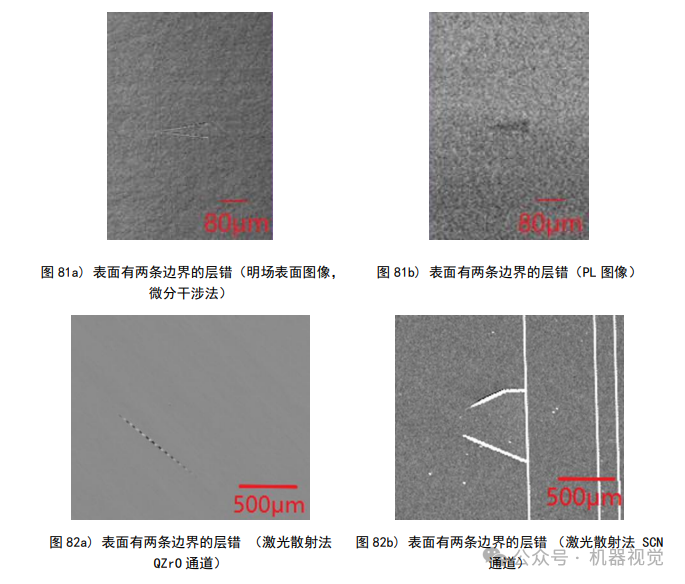
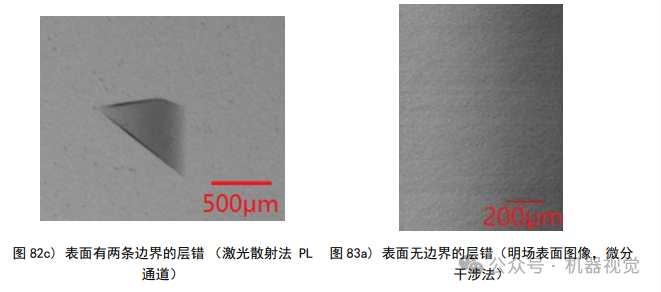
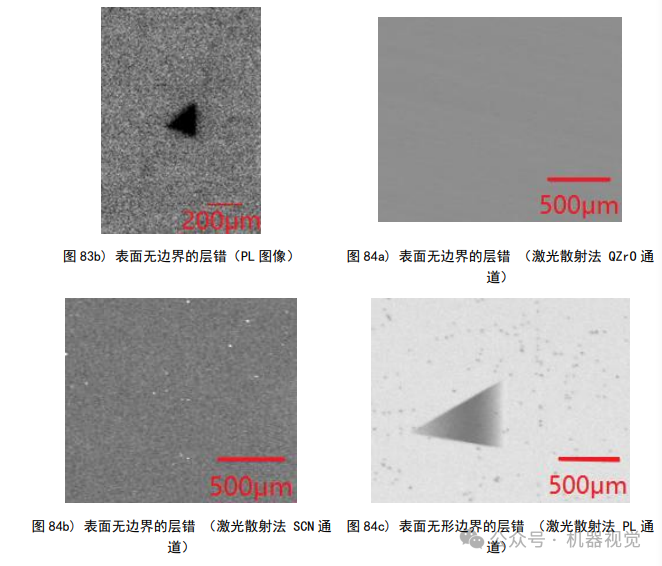
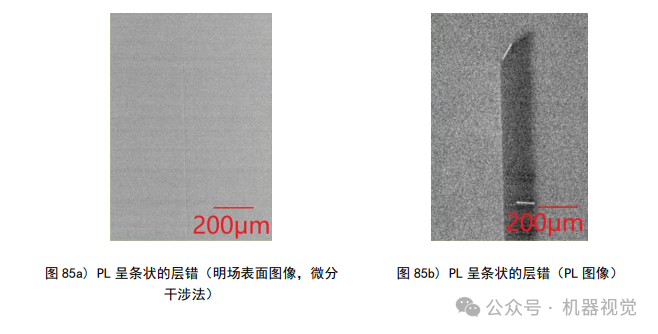
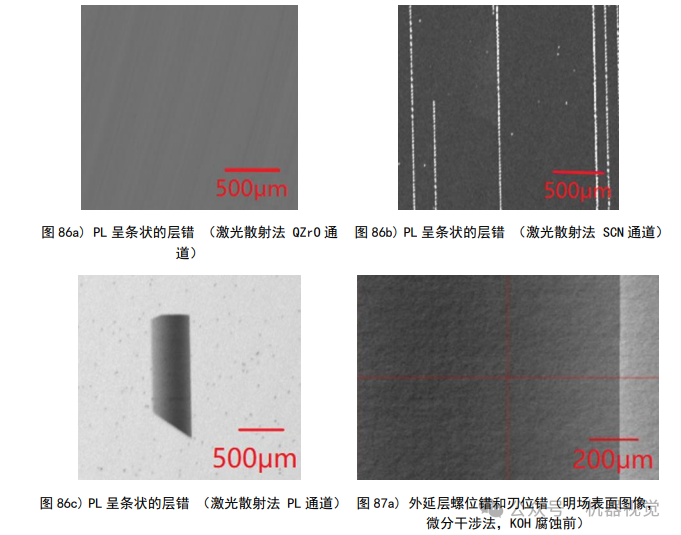
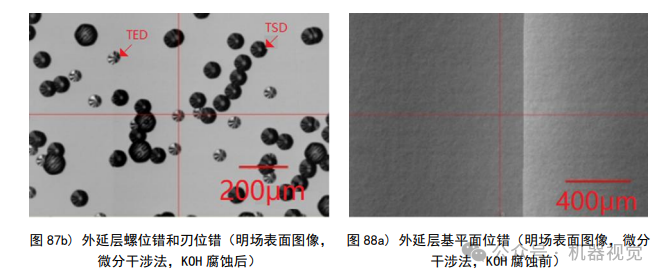
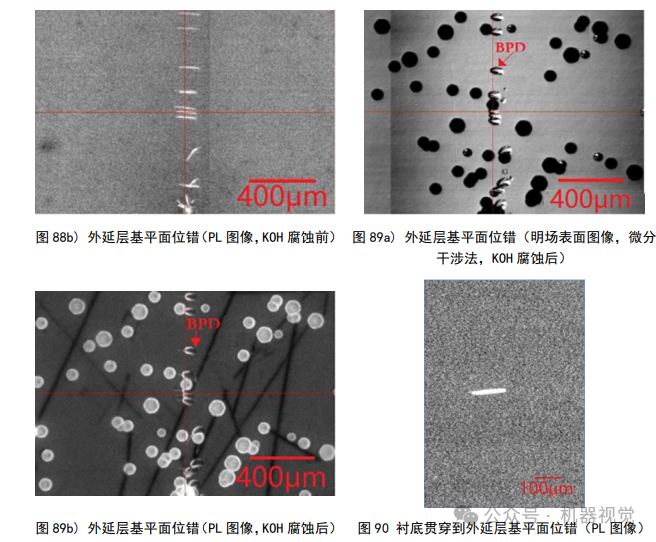
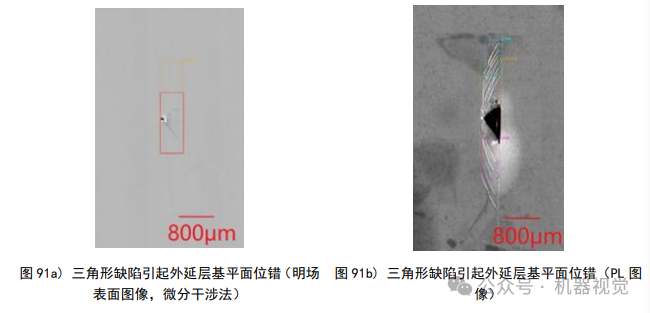
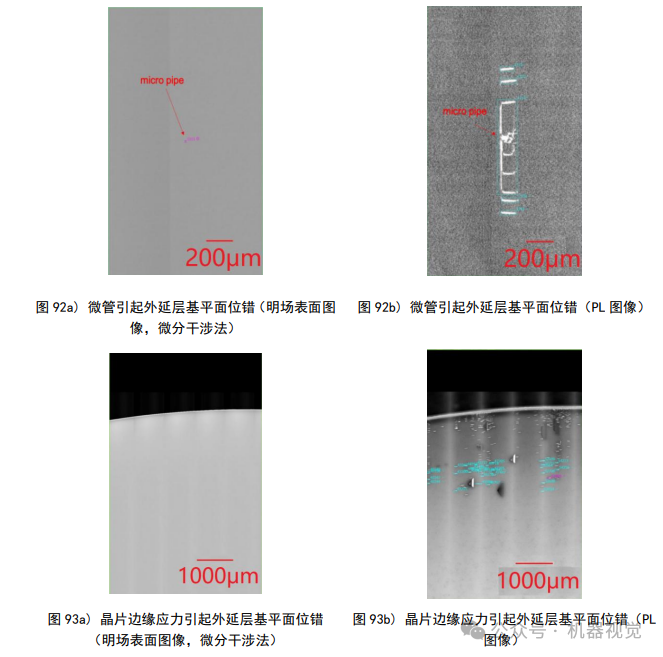
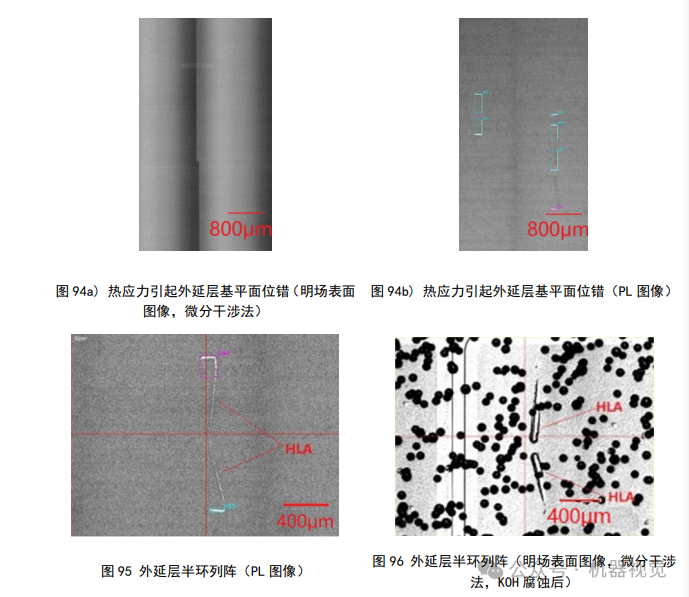
(四)工藝缺陷
在器件制造或材料改性工藝過程中,可能會引入一些深能級中心或非本征結晶缺陷。工藝缺陷主要包括以下幾種:
1.?氧化缺陷
- 特征:高溫氧化過程中形成的深能級中心或層錯。
- 產生原因:硅和碳原子相分離,形成硅團簇和碳團簇,導致界面碳團簇的形成和位錯遷移。
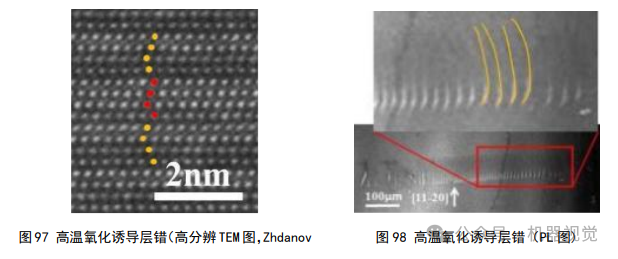
- 2.?電應力誘導三角形層錯
- 特征:PL圖像和EL圖像中呈現三角形圖案。
- 產生原因:襯底中的BPD在電子空穴復合驅動下分解為兩個不全位錯并滑移擴展。
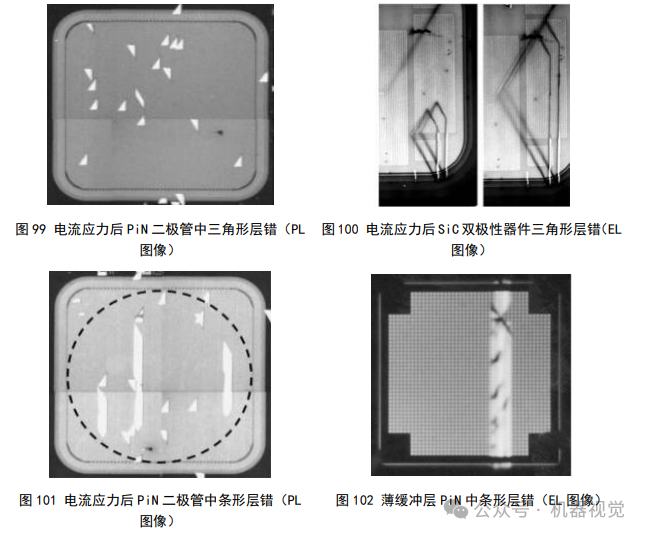
3.?電應力誘導條形層錯
- 特征:PL圖像和EL圖像中呈現條形圖案。
- 產生原因:外延層/襯底界面由BPD轉化而形成的TED誘導條形層錯擴展。
4.?干法刻蝕缺陷
- 特征:刻蝕工藝在4H-SiC外延層表面和側壁產生不可逆的結晶缺陷。
- 產生原因:刻蝕工藝在表面和側壁產生點缺陷或位錯環,誘發層錯及其擴展。
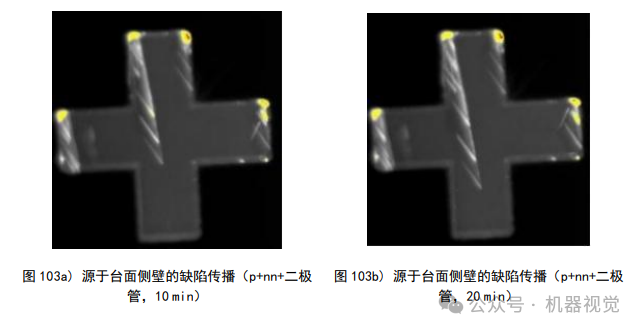
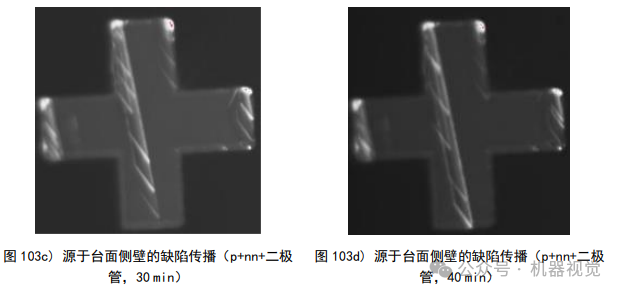

)









解題報告 | 珂學家)

- 首頁數據業務視圖)





