????????晶圓鍵合是一種晶圓級封裝技術,用于制造微機電系統 (MEMS)、納米機電系統 (NEMS)、微電子學和光電子學,確保機械穩定和氣密密封。用于 MEMS/NEMS 的晶圓直徑范圍為 100 毫米至 200 毫米(4 英寸至 8 英寸),用于生產微電子器件的晶圓直徑最大為 300 毫米(12 英寸)。
在微納加工 (MEMS / NEMS) 中,封裝可保護敏感的內部結構免受溫度、濕度、高壓和氧化物質等環境影響。內部功能元器件的長期穩定性和可靠性取決于封裝工藝,這部分封裝工藝也占了整體成本的很大比重。比如 MEMS壓力傳感器 的加工中就會涉及到晶圓鍵合這個工藝步驟。

圖1-壓力傳感器加工中的鍵合工藝
晶圓鍵合需要特定的環境條件等參數,通常有下面幾項變量:
-
基材表面
-
平整度
-
清潔度
-
鍵合環境(溫度、壓力)
-
施加的力
實際的鍵合效果會受到這些變量的相互作用影響。因此,需要根據當前晶圓基材和鍵合的規格定義來選擇相應的參數。
此外,為了評估鍵合工藝的產量、強度和氣密性水平,還需要對鍵合晶圓進行表征,一般的表征方法有:
-
破壞性技術,例如對鍵合以后的晶圓進行拉伸或剪切測試
-
非破壞性技術,例如用光學方法來發現裂紋或界面空隙,以評估粘合強度
-
非破壞性技術,還可以某些氣體、液體進行填充,用于氣密性測試
鍵合工藝可以細分為如下幾種技術:
-
直接鍵合(Direct bonding)
-
表面活化鍵合(Surface activated bonding)
-
等離子激活鍵合(Plasma activated bonding)
-
陽極鍵合(Anodic bonding)
-
共晶鍵合(Eutectic bonding)
-
玻璃熔塊鍵合(Glass frit bonding)
-
粘接(Adhesive bonding)
-
熱壓鍵合(Thermocompression bonding)
-
反應鍵合(Reactive bonding)
-
瞬態液相擴散鍵合(Transient liquid phase diffusion bonding)
-
原子擴散鍵合(Atomic diffusion bonding)
-
臨時鍵合(Temporal Silicon Bonding)
我們主要介紹其中三種:直接鍵合(Direct bonding)、陽極鍵合(Anodic bonding)、共晶鍵合(Eutectic bonding)。
直接鍵合(Direct bonding)
硅直接鍵合,也稱為硅熔合鍵合,是一種能夠牢固地連接兩個硅片的工藝,主要利用機械力和高于700攝氏度的高溫將兩個硅片鍵合在一起。
它的出現是 20 世紀 80 年代高頻和抗輻射 CMOS 應用 SOI 技術發展的重要一步。這一概念在后來擴展到壓力傳感器和加速度計的制造,現在已成為 MEMS 工具箱中的一項重要技術。

圖2-SOI晶圓中的鍵合
硅直接鍵合可以在兩個裸露的單晶硅表面或拋光的多晶硅之間進行。為了實現均勻且無空隙的鍵合,表面必須沒有顆粒和化學污染,如在 100 毫米晶圓上平坦度在 5 μm 以內。具體的鍵合過程從對硅片表面進行清潔和水合開始。以下是典型的順序:
-
首先,在熱 Piranha(硫酸和過氧化氫)溶液中對晶圓進行預清洗。?
-
將它們浸入稀釋的 HF 溶液中,蝕刻掉天然氧化物(或熱氧化物表面)并去除氧化物中捕獲的污染物。
-
進行 RCA-1 清潔(熱氫氧化銨和過氧化氫溶液)清潔,旨在去除有機物。
-
進行 RCA-2 清潔(熱鹽酸和過氧化氫溶液)以去除金屬污染物。所有熱的過氧化氫溶液都會在表面形成鍵合所需的羥基 (-OH)。這稱為水合作用。
-
小心地使粘合表面接觸并通過范德華力保持在一起。
-
根據反應,在 800° 至 1,100°C 下退火幾個小時可促進并強化結合。

圖3-直接鍵合流程
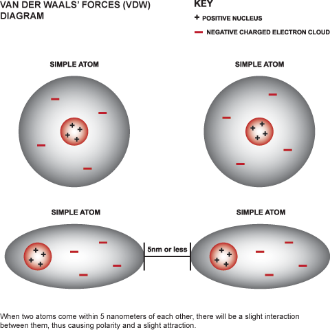
圖4-范德華力 Van Der Waals forces
當然,實際鍵合過程中,分子間相互作用有多種,范德華力是其中之一,其他還有氫鍵和共價鍵。
在某些情況下,兩個硅片表面上的圖形化特征必須在鍵合之前彼此對準。例如,一個硅片中的空腔需要對接連接到第二個硅片提供的入口。這需要特殊設備來執行對準和鍵合,SüSS MicroTec 和 EV Group 這兩家設備制造商就有類似的技術方案,大體過程是:
-
將晶圓依次安裝在特殊的機械夾具中,并以類似于光刻中雙面對準的方式與彼此面對的兩個鍵合表面對準。
-
機械夾具將對齊的晶圓固定到位,晶圓邊緣由薄墊片隔開。
-
使晶圓的中心接觸并去除間隔物,使鍵合區域從晶圓中心延伸到邊緣。對準的相對錯位通常小于 5 μm,最高可達 1 μm。

圖5-EV Group的鍵合機臺
陽極鍵合(Anodic bonding)
陽極鍵合,是一種將硅片和含鈉玻璃基板(例如 Borofloat 33)連接在一起的鍵合工藝。它用于制造各種傳感器,為硅片提供了剛性支撐。
鍵合過程在真空、空氣或惰性氣體環境中、在200°C至500°C之間的溫度下進行。在兩個基板上施加 500 至 1,500V 的電壓,同時玻璃保持在負電勢,導致玻璃中的移動正離子(主要是 Na + )從硅-玻璃界面向陰極遷移,留下固定的負離子。玻璃中固定的負離子與硅片的正電荷之間的靜電引力將兩個基板固定在一起,并促進玻璃與硅的化學鍵合。當離子電流(在外部測量為電子電流)消失時,鍵合完成,表明所有移動離子已到達陰極。

圖6-玻璃和硅之間的陽極鍵合示意圖
玻璃基板的熱膨脹系數優選與硅的熱膨脹系數匹配,以便最小化熱應力。
共晶鍵合(Eutectic bonding)
共晶鍵合,也稱為共晶焊接,是兩種或多種金屬的組合允許在特定溫度下直接從固態轉變為液態。共晶溫度遠低于鍵合過程中涉及的材料的熔化溫度。共晶鍵合廣泛用于 MEMS 行業的氣密密封、壓力或真空封裝。
共晶鍵合中最常用的金屬/合金是 Al-Ge、Au-Sn 和 Au-In,還有許多其他材料組合可以產生共晶鍵合系統。此外,硅與金等金屬形成合金的能力也可以成為共晶鍵合的基礎。所有共晶鍵必須經過液相,因此對表面平整度不規則性、劃痕和顆粒不太敏感,從而有利于大批量生產。
鍵合溫度、時間和壓力是共晶鍵合最重要的參數,共晶鍵合可以在較低的加工溫度和最小的合成應力下實現高鍵合強度。共晶鍵合還可在單一工藝中實現氣密密封和電氣互連。與其他中間層(例如粘合劑或玻璃料)相比,共晶鍵合還可以促進更好的排氣和氣密性。

圖7-GaAs/InP 晶圓中的 Au-Sn 共晶金屬鍵合
(源自EVG官網)
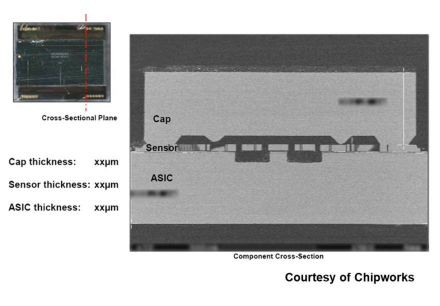
圖8-MEMS/ASIS 晶圓中的 Al-Ge 共晶鍵合




【debug篇】)
——集成技術(Bagging——隨機森林分類器和回歸))



【第六屆傳智杯-新增場次-程序設計挑戰賽解題分析詳解復盤】)









